ICAN: Focused Ion Beam
Was kann ein Focused Ion Beam?
Die Arbeitsgruppe von Prof. Dr. Lorke nutzt ein FIB/SEM DualBeam™ Mikroskop der Firma FEI als „Nanowerkbank“ zur Probenpräparation im Nanometer-Maßstab. Mit diesem Gerät ist es zum einen - wie bei einem klassischen Rasterelektronenmikroskop (SEM) - möglich Aufnahmen von Proben mit sehr hoher Auflösung zu erstellen und zum anderen Proben mit Hilfe von Gallium-Ionen zu strukturieren. Die Abkürzung FIB steht für Focused Ion Beam. Beide Möglichkeiten sind hier in einem Gerät vereinigt.
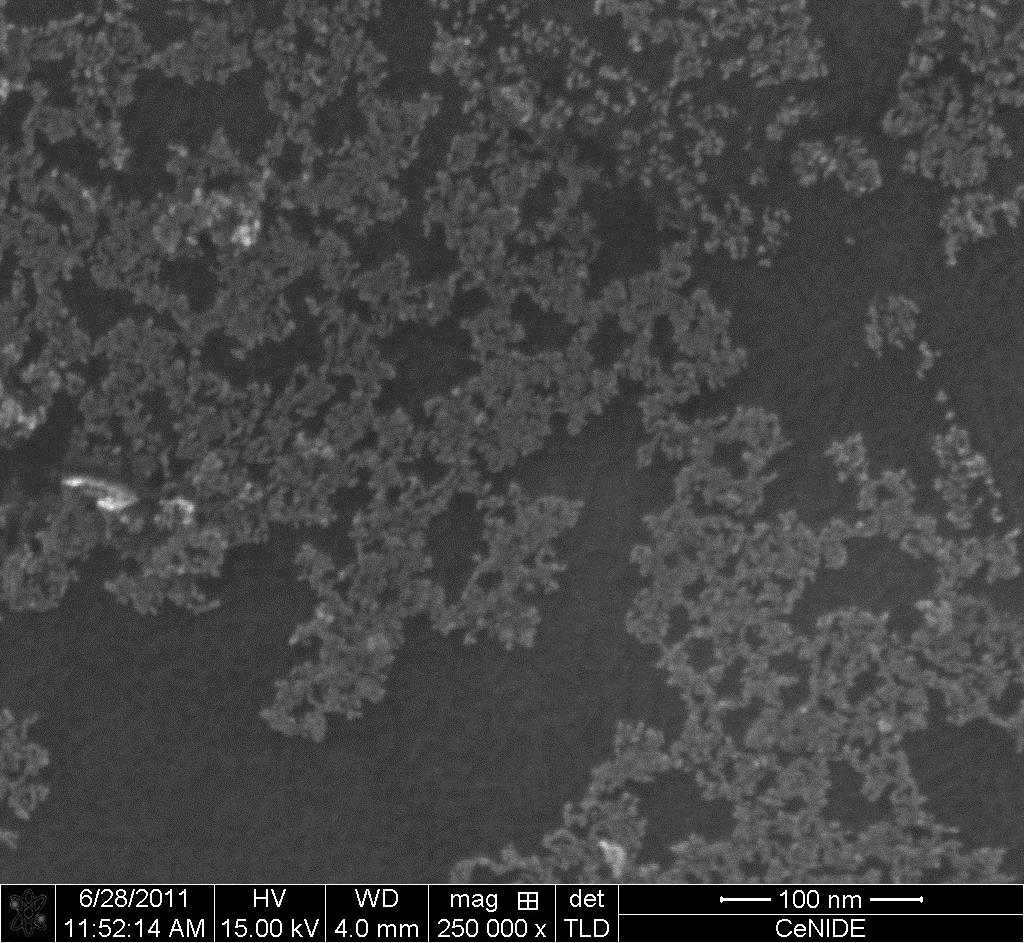
Abbildung 1: Pt-Nanopartikel auf einem Graphen-Nanoplatelet [1].
Abbilden mittels SEM und FIB
Das Abbilden von Probenoberflächen ist mit dem Elektronenstrahl sowie dem Ionenstrahl bis zu einer Auflösung von ca. 1 nm bzw. 5 nm möglich. Abbildung 1 zeigt eine Aufnahme mit dem Elektronenstrahl von Pt-Nanopartikeln auf Graphen-Nanoplatelets [1]. Die Pt-Partikel haben einen Durchmesser von ca. 4 nm.
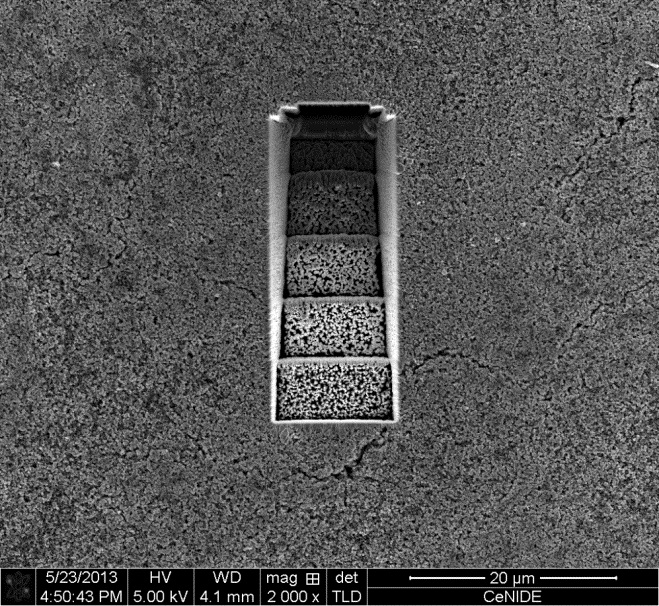
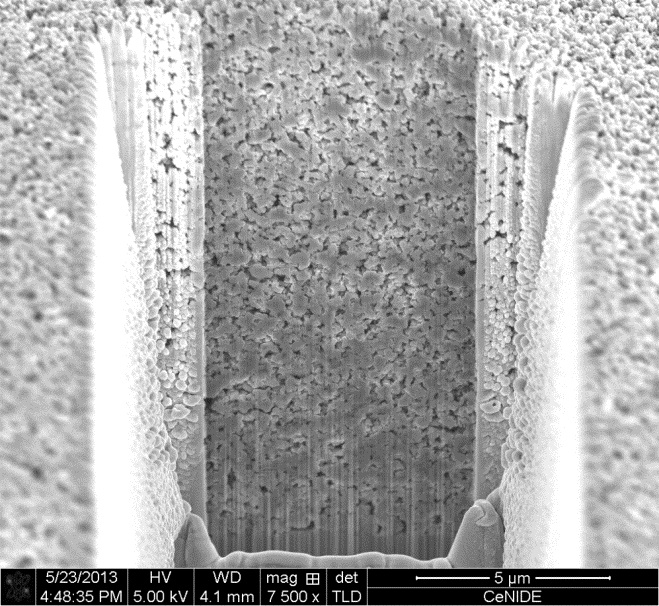
Abbildung 2: Elektronenmikroskopische Aufnahme eines mit dem Ionenstrahl präparierten Querschnitts durch eine Elektrode für eine Li-Batterie Draufsicht (links), Ansicht des Querschnitts (rechts).

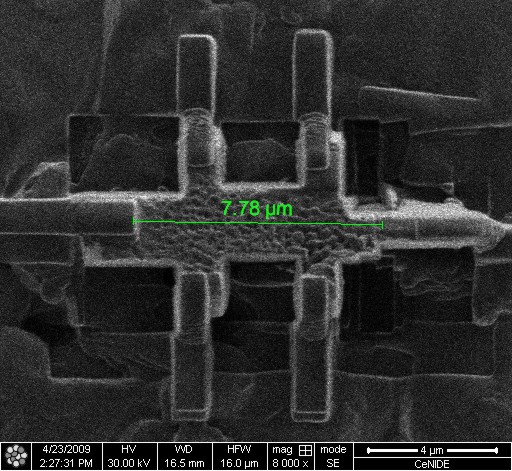
Abbildung 3: Mit dem Ionenstrahl in ein Haar strukturierter CENIDE-Schriftzug (links, nachträglich eingefärbt), Mit dem Ionenstrahl aus einem nanoporösen Indium-Zinn-Oxid-Film strukturierte Hall-Messgeometrie (rechts) [2].
Schneiden und Strukturieren
Mit Hilfe des Ionenstrahls ist es möglich, eine laterale Strukturierung von Proben vorzunehmen, aber auch in die Probe hinein zu schneiden, um Querschnitte der Proben (Abb. 2) zu untersuchen. Die Strukturierung kann durch Einsatz des Ionenstrahls (Abb. 3), durch Einsatz des Ionenstrahls unter Zuhilfenahme von zusätzlichen Ätzgasen oder auch durch den Einsatz des Elektronenstrahls unter Zuhilfenahme von zusätzlichen Ätzgasen (Abb. 4) realisiert werden. Als zusätzliche Ätzgase stehen hierfür Xenondifluorid (XeF2), Selective Carbon Etch (SCE) und Iod zur Verfügung. Die erreichbare Auflösung hängt stark vom Materialsystem und der Leitfähigkeit der Proben ab.


Abbildung 4: Mit XeF2 und dem Elektronenstrahl in GaAs geätzter Graben mit einer Breite von 30 nm (links) [3]. Mit SCE und dem Elektronenstrahl geätzte Gräben in Graphen mit Breiten von 15 nm bis 35 nm (rechts).
Lokale Materialdeposition
Zusätzlich gestattet dieses Gerät die Deposition von Platin, als leitendes Material, und Siliziumoxid, als isolierendes Material. Die Platindeposition, die sowohl mit dem Ionenstrahl als auch mit dem Elektronenstrahl erfolgen kann, wird dazu genutzt in die Probe strukturierte Messgeometrien (siehe z.B. Abb. 3 rechts) zu kontaktieren oder um die Probe bei der Herstellung zum Beispiel einer Lamelle für die Transmissionselektronenmikroskopie (TEM) vor Strahlenschäden, die durch den Ionenstrahl verursacht werden, zu schützen. Abbildung 5 zeigt einige Platinleiterbahnen unterschiedlicher Breite, die mit diesem Verfahren abgeschieden wurden.
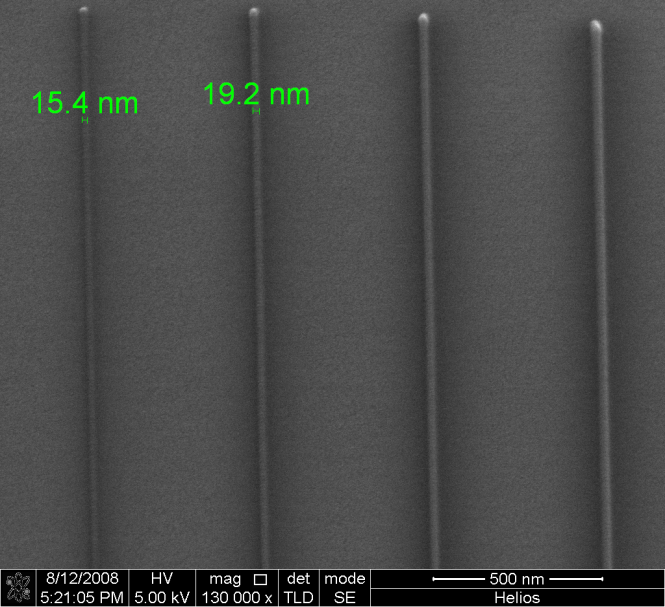
Abbildung 5: Mit einem Elektronenstrahl abgeschiedene Platinbahnen.
Präparation von TEM-Lamellen
Für eine Untersuchung mittels TEM ist es notwendig eine sehr dünne Lamelle zu präparieren. Dies kann auf herkömmliche Weise durch Polieren erreicht werden. Es ist aber auch möglich mittels des Ionenstrahls eine solche TEM-Lamelle heraus zu schneiden (siehe Abb. 6 links). Ein wesentlicher Vorteil dieser Methode ist es, dass man sich vorher mittels des SEM genau die Stelle aussuchen kann, an der die TEM-Lamelle präpariert werden und somit die Analyse via Raster-Transmissionselektronenmikroskopie (STEM) stattfinden soll. Zusätzlich bietet das Gerät auch direkt die Möglichkeit einer STEM-Analyse einer solchen TEM-Lamelle. Ein entsprechendes Ergebnis ist in Abbildung 6 (rechts) dargestellt. Man erreicht maximale Auflösungen im Bereich von ca. 0,8 nm.
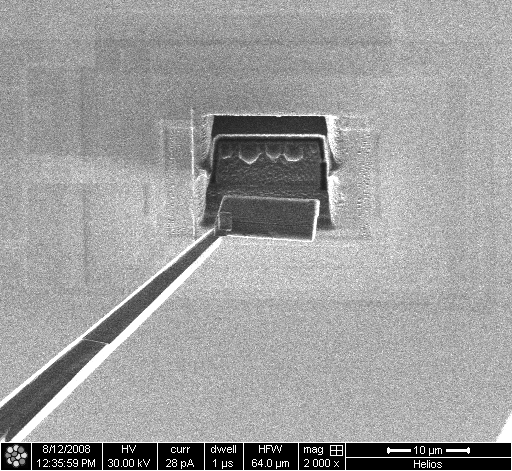
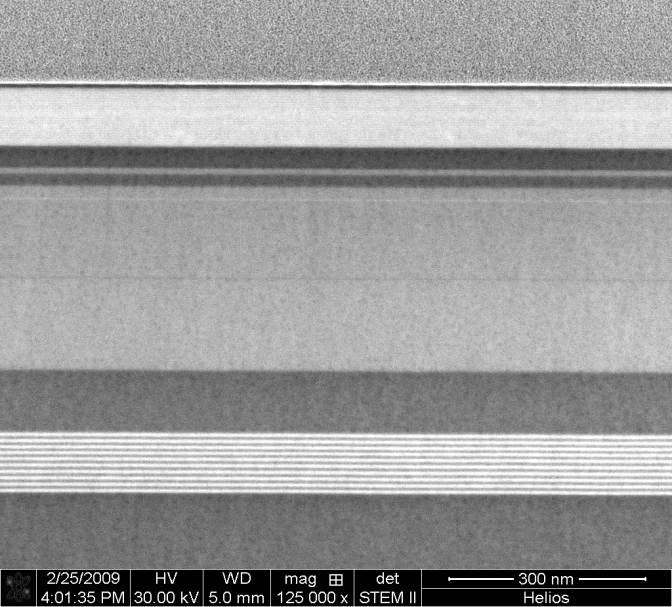
Abbildung 6: Mit dem Ionenstrahl präparierte TEM-Lamelle am Mikro-Manipulator zum Transfer auf den TEM-Probenhalter (links). STEM-Aufnahme einer GaAs-Probe mit unterschiedlichen funktionellen Schichten (rechts, Auflösung ca. 1 nm).
Veröffentlichungen
- A. Marinkas, F. Arena, J. Mitzel, G. M. Prinz, A. Heinzel, V. Peinecke, and H. Natter, Carbon 58 (2013) 139-150
- A. Gondorf, M. Geller, J. Weißbon, and A. Lorke Phys. Rev. B 83, 212201 (2011)
- A. Ganczarczyk, M. Geller and A. Lorke Nanotechnology 22 (2011) 045301


