ICAN: Focused Ion Beam
Was kann ein Focused Ion Beam?
Die Arbeitsgruppe von Prof. Dr. Lorke nutzt ein FIB/SEM DualBeam™ Mikroskop der Firma FEI als „Nanowerkbank“ zur Probenpräparation im Nanometer-Maßstab. Mit diesem Gerät ist es zum einen - wie bei einem klassischen Rasterelektronenmikroskop (SEM) - möglich Aufnahmen von Proben mit sehr hoher Auflösung zu erstellen und zum anderen Proben mit Hilfe von Gallium-Ionen zu strukturieren. Die Abkürzung FIB steht für Focused Ion Beam. Beide Möglichkeiten sind hier in einem Gerät vereinigt.
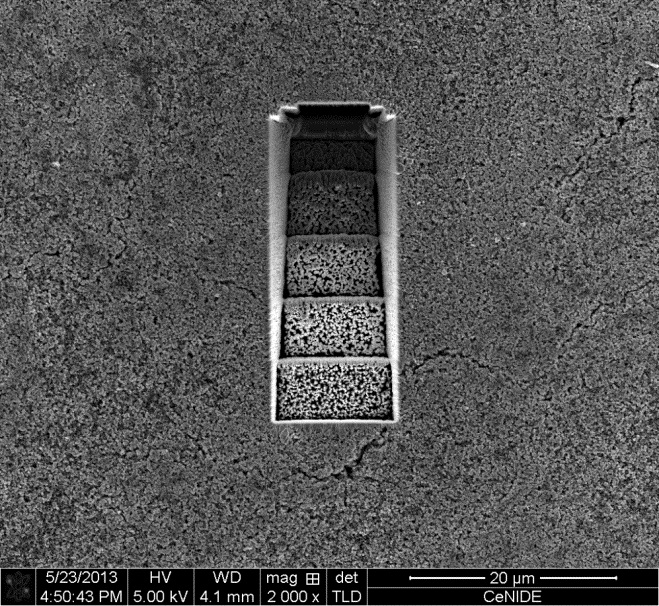
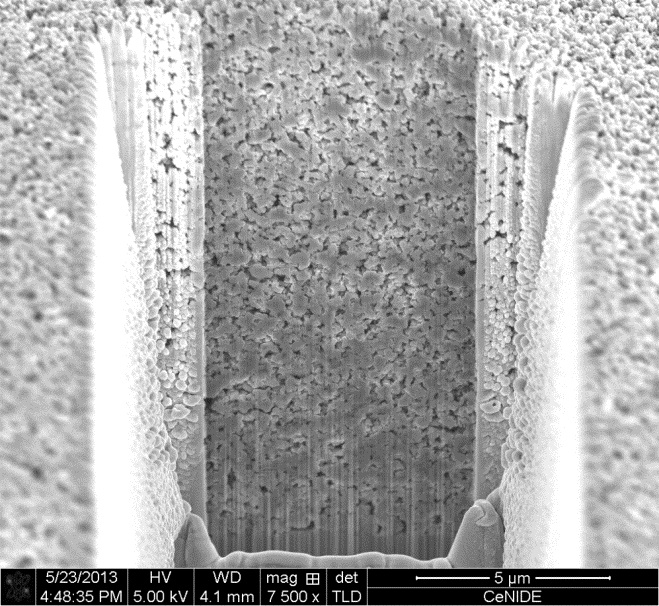
Abbildung 1: Elektronenmikroskopische Aufnahme eines mit dem Ionenstrahl präparierten Querschnitts durch eine Elektrode für eine Li-Batterie Draufsicht (links), Ansicht des Querschnitts (rechts).

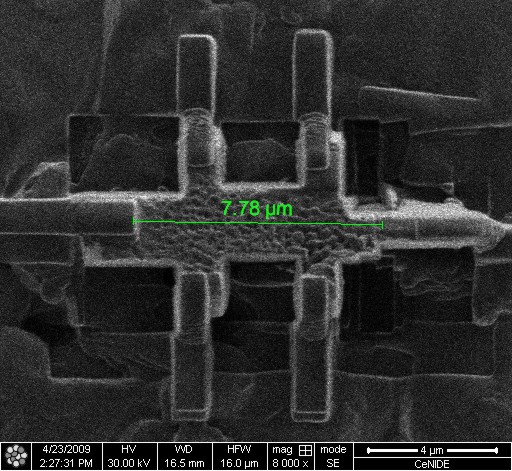
Abbildung 2: Mit dem Ionenstrahl in ein Haar strukturierter CENIDE-Schriftzug (links, nachträglich eingefärbt), Mit dem Ionenstrahl aus einem nanoporösen Indium-Zinn-Oxid-Film strukturierte Hall-Messgeometrie (rechts) [2].




